- 善仁新材料科技有限公司 導電銀漿,導電銀膠,導電油墨,低溫燒結納米銀漿,無壓燒結銀,,導熱膠
- 全國服務熱線
劉先生:13611616628
優勢產品:燒結銀、無壓燒結銀,有壓燒結銀,半燒結納米銀膏、納米銀墨水、導電膠、導電銀漿、導電油墨、銀/氯化銀、納米銀漿、可拉伸銀漿、燒結銀膜、納米焊料鍵合材料、UV銀漿、光刻銀漿、UV膠、導熱絕緣膠、DTS預燒結銀焊片、導電銀膜、銀玻璃膠粘劑,納米銀膠、納米銀膏、可焊接低溫銀漿、高導熱銀膠、導電膠等產品,擁有完善的納米顆粒技術平臺,金屬技術平臺、樹脂合成技術平臺、同位合成技術平臺,粘結技術平臺等。
 善仁新材料科技有限公司
善仁新材料科技有限公司






在半導體封裝領域,芯片散熱始終是制約高性能器件發展的關鍵挑戰。燒結銀膏(Sintered Silver Paste)作為一種新型無鉛化互連材料,憑借其高導熱性、高可靠性及低溫工藝兼容性,成為解決高功率芯片散熱難題的“秘密武器”。以下從技術原理、核心優勢、應用場景及挑戰等方面展開分析。
燒結銀膏的核心在于納米銀顆粒的固態擴散機制。其制備過程通常包含以下步驟:
材料組成:以納米銀粉(粒徑<100 nm)為主體,混合有機載體(粘結劑、溶劑)及微量添加劑(如抗氧化劑、分散劑)形成膏狀物。
燒結過程:在150-300℃下,通過表面自由能驅動和原子擴散,納米銀顆粒逐漸形成燒結頸,較終形成多孔銀層(孔隙率約10%-20%)。此過程無需熔融銀(熔點961℃),且可通過加壓(1-5 MPa)或無壓工藝實現致密化。
性能表現:燒結后銀層熱導率可達240 W/m·K(純銀的90%),遠超傳統焊料(如Sn-Ag-Cu焊料熱導率約50 W/m·K)。
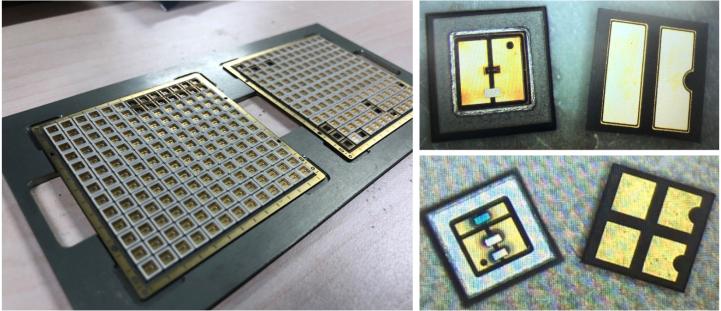
AS9335燒結銀膏
高導熱與低熱阻燒結銀膏的熱導率是傳統焊料的2-4倍,可快速導出芯片熱量,降低結溫(如SiC模塊結溫從150℃提升至200℃以上)。
在5G射頻模塊中,燒結銀膏可將信號傳輸損耗降低20%,**高頻穩定性。
低溫工藝兼容性燒結溫度可低至150℃(如AS9335型號),避免高溫對GaN、SiC等寬禁帶半導體芯片的損傷,同時減少熱應力導致的焊點開裂風險。
高可靠性燒結層為純銀結構,無鉛無鹵素,符合RoHS標準;剪切強度達30 MPa,抗電遷移性能優異,熱循環壽命(-55~175℃)可達1000次以上。
在新能源汽車電池管理系統(BMS)中,燒結銀膏將熱阻降低50%,延長電池壽命20%。
輕薄化與高集成度銀層厚度可控制在10-50 μm,替代傳統焊料和鍵合線,縮小封裝體積,提升功率密度(如IGBT模塊功率密度提升30%)。
新能源汽車功率模塊:燒結銀膏AS9385用于SiC MOSFET封裝,支持兆瓦級閃充,系統效率提升8%-12%。
電池管理:降低BMS熱阻,提升散熱效率。
5G通信與數據中心射頻前端:5G基站采用燒結銀膏AS933X1實現芯片高密度互連,信號損耗降低20%,單機功耗減少10W。
AI芯片:英偉達H100 GPU通過3D堆疊封裝技術,算力密度突破60 TOPS/mm3,散熱效率提升3倍。
航空航天與**在衛星、雷達等極端環境(-55~400℃)中,燒結銀膏AS9335保持穩定性能,滿足抗輻射與耐高溫需求。
消費電子智能手機芯片封裝中,燒結銀膏兼顧輕薄化與高效散熱,提升用戶體驗。
當前挑戰工藝控制:燒結溫度、壓力、時間的精準匹配直接影響性能,需開發智能化工藝設備。
成本問題:納米銀粉制備成本高(約是傳統焊料的5-10倍),需優化規模化生產工藝。
檢測技術:燒結層內部微米/亞微米級孔隙的檢測方法尚未成熟,影響可靠性評估。
技術突破方向低溫低壓工藝:開發無壓燒結技術(如AS9375),燒結溫度低至130℃,壓力<1 MPa,降低設備成本。
復合銀膏:添加銅、鎳等金屬顆粒,提升導熱性并降低成本。
環保替代:探索無有機載體配方,減少生產過程中的化學污染。
AS燒結銀膏通過納米銀顆粒的固態擴散機制,實現了芯片散熱性能的跨越式提升。其高導熱、低溫工藝兼容性及可靠性,使其在新能源汽車、5G通信、AI芯片等領域成為不可替代的散熱解決方案。盡管面臨成本與工藝控制的挑戰,但隨著材料科學和制造工藝的進步,AS燒結銀膏有望進一步推動半導體封裝技術向高功率密度、微型化、綠色化方向發展,重塑全球半導體產業格局。
銷售熱線
13611616628